
Un estudio publicado recientemente en Advanced Science por investigadores de la Universidad de Osaka propone una nueva tecnología para dispositivos MRAM con escritura de datos de menor demanda de energía. La tecnología propuesta permite un esquema de escritura basado en campos eléctricos con un consumo de energía reducido en comparación con el enfoque actual, proporcionando potencialmente una alternativa a la RAM tradicional.
Los dispositivos de RAM dinámica (DRAM) convencionales tienen unidades de almacenamiento básicas que constan de transistores y condensadores. Sin embargo, los datos almacenados son volátiles, lo que significa que se requiere un aporte de energía para retenerlos. Por el contrario, MRAM utiliza estados magnéticos, como la orientación de la magnetización, para escribir y almacenar datos, lo que permite el almacenamiento de datos no volátiles.
“Dado que los dispositivos MRAM dependen de un estado de magnetización no volátil en lugar de un estado de carga volátil en los condensadores, son una alternativa prometedora a la DRAM en términos de su bajo consumo de energía en el estado de espera”, explicó Takamasa Usami, autor principal del estudio.
Los dispositivos MRAM actuales generalmente requieren una corriente eléctrica para cambiar los vectores de magnetización de las uniones de túnel magnético, de forma análoga a cambiar los estados de carga del condensador en un dispositivo DRAM. Sin embargo, se necesita una gran carga de corriente eléctrica para cambiar los vectores de magnetización durante el proceso de escritura. Esto da como resultado un inevitable calentamiento Joule, lo que provoca un importante consumo de energía.
Para resolver el problema, los investigadores desarrollaron un nuevo componente para el control del campo eléctrico de dispositivos MRAM. La tecnología clave es una heteroestructura multiferroica con vectores de magnetización que pueden conmutarse mediante un campo eléctrico (Figura destacada). La respuesta de la heteroestructura a un campo eléctrico se caracteriza básicamente en términos del coeficiente de acoplamiento magnetoeléctrico inverso (CME); los valores más grandes indican una respuesta de magnetización más fuerte.
Los investigadores informaron previamente de una heteroestructura multiferroica con un gran coeficiente de acoplamiento CME de más de 10-5 s/m. Sin embargo, las fluctuaciones estructurales en partes de la capa ferromagnética (Co2FeSi) dificultaron el logro de la anisotropía magnética deseada, lo que dificultó el funcionamiento confiable del campo eléctrico. Para mejorar la estabilidad de esta configuración, los investigadores desarrollaron una nueva tecnología para la inserción de una capa ultrafina de vanadio entre las capas ferromagnética y piezoeléctrica. Como se muestra en la Fig. 2, se logró una interfaz clara al insertar la capa de vanadio, lo que condujo a un control confiable de la anisotropía magnética en la capa de Co2FeSi. Además, el efecto CME alcanzó un valor mayor que el logrado con dispositivos similares que no incluían una capa de vanadio.
“A través del control preciso de las heteroestructuras multiferroicas, se satisfacen dos requisitos clave para implementar dispositivos prácticos magnetoeléctricos (ME)-MRAM, a saber, un estado binario no volátil con campo eléctrico cero y un efecto CME gigante”, dijo Kohei Hamaya, autor principal del estudio.
Esta investigación en dispositivos espintrónicos podría eventualmente implementarse en dispositivos MRAM prácticos, permitiendo a los fabricantes desarrollar ME-MRAM, que es una tecnología de escritura de bajo consumo para una amplia gama de aplicaciones que requieren que la memoria sea persistente y segura.
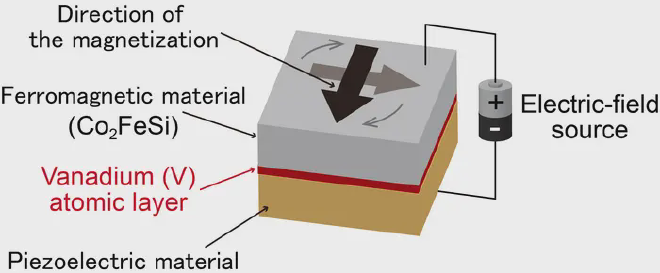
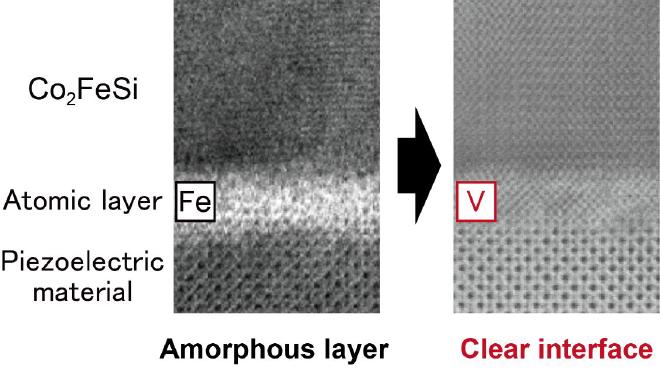
- El paper “Artificial control of giant converse magnetoelectric effect in spintronic multiferroic heterostructure,” fue publicado en Advanced Science. Autores: Takamasa Usami, Yuya Sanada, Shumpei Fujii, Shinya Yamada, Yu Shiratsuchi, Ryoichi Nakatani, Kohei Hamaya

